在众多太阳电池中,晶硅电池因光电转换效率高、成本低,近年来发展迅速,其中高转换效率的电池结构如隧穿氧化钝化接触(TOPCon)和本征薄膜异质结(HJT)等成为未来太阳电池的研究重点。
2013年,德国Fraunhofer太阳能研究所提出TOPCon电池的概念,近几年来,在科学家的不断努力下,TOPCon电池已经成为最具发展前景的高效太阳电池之一。
TOPCon技术的关键在于超薄隧穿氧化硅层和掺杂多晶硅层的应用。超薄隧穿氧化硅层能够降低隧穿电阻并减少表面态,掺杂多晶硅层能够提供背面场钝化和优异的接触。
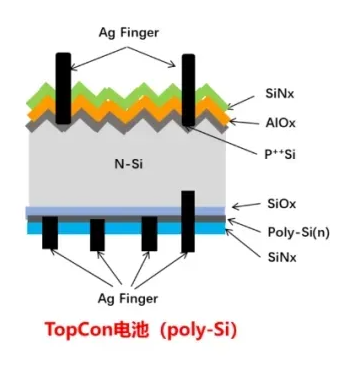
这种结构提供了全面积的表面钝化,超薄隧穿氧化硅层的隧穿效应能实现电子的顺利输运,掺杂多晶硅薄膜的存在使金属电极不与硅衬底直接接触从而实现优异的接触,以上优势能够使开路电压和填充因子得到有效提升。
随着技术的进步,TOPCon电池的光电转换效率不断提升,目前已经达到25.8%,行业内其平均光电转换效率为23.6%~24%。

TOPCon结构的核心为掺杂多晶硅层,如何提升多晶硅层的质量成为进一步提升TOPCon电池光电转换效率的关键因素。
制备多晶硅薄膜的方法有低压化学气相沉积(LPCVD)法、等离子体增强化学气相沉积(PECVD)法和常压化学气相沉积(APCVD)法,其中LPCVD制备多晶硅薄膜是在低压氛围下进行,气体环境更容易控制,反应气体的扩散系数大,因此成膜质量更好,成膜速度更快。
LPCVD制备多晶硅薄膜的过程如下:硅烷气体通入炉管并保持稳定压力,硅烷分子扩散至硅片表面;高温环境下,硅烷分子分解,生成硅原子、氢原子等产物,硅原子在硅片表面沉积,并与硅晶体结合,而副产物通过真空泵排出设备。
TOPCon电池以n型硅片为衬底,清洗制绒后,前表面从内至外依次为硼掺杂发射极、SiO2+AlOx钝化层、具有减反钝化作用的SiNx层和金属电极,后表面从内至外依次为隧穿SiOx层、磷掺杂多晶硅层、SiNx层和金属电极,TOPCon电池结构如图1所示。
按照图2所示流程制备实验样品,采用面积252cm2、厚度170μm的n型硅片进行样品制备。
图2 样品制备流程
先在60℃、质量分数为2.5%的KOH溶液中抛光,并进行RCA清洗;再利用LPCVD设备双面制备隧穿氧化硅层和多晶硅薄膜层;然后用管式扩散炉在890℃高温条件下进行双面磷扩散,扩散后使用质量分数为10%的HF清洗去除表面磷硅玻璃层;之后采用PECVD设备在硅片正、背面沉积具有减反和钝化作用的氮化硅层;最后进行退火。
为了研究生长工艺对多晶硅薄膜生长速率和钝化性能的影响,分别采用不同的沉积温度、硅烷体积流量和沉积时间来制备样品,并测试多晶硅薄膜生长速率及钝化性能。样品结构如图3所示。
使用SE800椭偏仪测试多晶硅薄膜厚度,每片样品测量25个点求平均值,并计算多晶硅薄膜生长速率;使用WCT120光电导少子寿命测试仪表征测试饱和电流密度和隐性开路电压,并进行分析。
多晶硅薄膜生长过程中,沉积温度会对其生长速率产生明显影响。为了研究沉积温度对多晶硅薄膜沉积速率的影响,按图2所示流程进行样品制备,样品共分为四组。
不同沉积温度下LPCVD制备多晶硅采用的工艺参数如表1(表中1Torr≈133.3Pa)所示,通过调整沉积时间控制多晶硅薄膜厚度为150nm。
表1 不同沉积温度下LPCVD制备多晶硅薄膜的工艺参数

图4为多晶硅薄膜生长速率随沉积温度的变化。从图4可知,在590、600、620和635℃沉积温度下,多晶硅薄膜的生长速率分别为4.8、6.0、9.1和13.9nm/min。
在590~635℃内,多晶硅薄膜生长速率对温度的变化非常敏感,随着温度增加,多晶硅薄膜生长速率明显增大。因此,在LPCVD制备多晶硅薄膜时,需要对温度进行精准控制,硅片表面的温度应尽量保证一致,才能获得均匀性好的多晶硅薄膜。
图5为不同沉积温度下样品的钝化性能。钝化性能随沉积温度的增加先变优再变差。当沉积温度为590℃时,隐性开路电压(Vioc)平均值为744mV,饱和电流密度(J0)平均值为1.70fA/cm2;
当沉积温度为600℃时,Vioc平均值为746mV,J0平均值为1.49fA/cm2,钝化性能最佳;当沉积温度升至635℃时,Vioc平均值降至727mV,J0平均值增至6.04fA/cm2。
这是由于当沉积温度较低时,多晶硅薄层质量不佳,影响了钝化效果;当沉积温度超过最佳温度继续升高时,多晶硅层被破坏,钝化性能变差。
LPCVD制备多晶硅薄膜采用的工艺气体为硅烷。在多晶硅薄膜生长过程中,到达硅片衬底的硅原子越多,薄膜的生长速率越快,因此硅烷体积流量的大小会显著影响多晶硅薄膜的生长速率。
为了研究硅烷体积流量与多晶硅薄膜沉积速率之间的关系,按照图2流程制备样品,样品共分为四组,不同硅烷体积流量下LPCVD制备多晶硅采用的工艺参数如表2所示,通过调整沉积时间控制多晶硅薄膜厚度为150nm。
表2 不同硅烷体积流量下LPCVD制备多晶硅薄膜的工艺参数

不同硅烷体积流量下多晶硅薄膜的生长速率结果如图6所示。从图6可知,在250、350、790和1150cm3/min硅烷体积流量下,多晶硅薄膜生长速率分别为3.3、4.5、6.0和7.5nm/min。在250~1150cm3/min内,多晶硅薄膜的生长速率与硅烷体积流量基本呈线性关系。
有研究数据表明,多晶硅薄膜生长速率与硅烷体积流量的关系为:当硅烷体积流量较小时,随着硅烷体积流量的增加,多晶硅薄膜生长速率迅速增加;当硅烷体积流量较大时,多晶硅薄膜生长速率增量变小,该结论可用流体力学的相关理论进行解释。当非光滑物体间存在相互运动时,接触面就会产生摩擦力。
因此,当气体流过固体表面时,气体分子会与固体表面产生一定的摩擦力,气体分子与固体表面越接近,摩擦力越大,气体的流动速度也就减小得越多,直至速度无限接近零。与固体表面相邻、流动速度受影响的这一薄层气体叫滞留层,气体流动的速度越大,滞留层的厚度就越薄。
因此,在多晶硅薄膜沉积过程中,硅烷气体的体积流量增大,硅烷分子流动的速度就会增大,硅片表面的滞留层就会减薄,到达硅片表面的反应物原子就会增多,多晶硅薄膜的生长速率就会随之增加。
硅烷体积流量较大时,滞留层对流体的影响基本可以忽略,因此当硅烷体积流量持续增大时,多晶硅薄膜的生长速率就不会继续随之增大。本实验表明,当硅烷体积流量小于1150cm3/min时,多晶硅薄膜生长速率随硅烷体积流量的增加呈线性增长。
当硅烷体积流量为250、350和790cm3/min时,Vioc平均值分别为744、745和745mV,基本一致;J0平均值分别为1.64、1.51和1.65fA/cm2,也基本一致,350cm3/min时钝化性能略优。当硅烷体积流量为1150cm3/min时,Vioc平均值为737mV,J0平均值为3.98fA/cm2,钝化性能明显变差。
这是由于当硅烷体积流量变大时,气相分解和副产物增多,影响了多晶硅薄膜的质量。而当硅烷体积流量过小时,又会影响沉积速率,综合考虑,采用790cm3/min的硅烷体积流量最佳。
根据LPCVD法沉积多晶硅薄膜原理,当只改变沉积时间时,多晶硅薄膜沉积速率不变。为了验证这一结论,按图2流程进行样品制备,样品共分为五组。不同沉积时间下LPCVD制备多晶硅薄膜采用的工艺参数如表3所示,通过调整沉积时间得到不同厚度的多晶硅薄膜。
表3 不同沉积时间下LPCVD制备多晶硅薄膜的工艺参数

不同沉积时间下多晶硅薄膜生长速率结果如图8所示。从图8可知,8、16、24、33和40min沉积时间下,多晶硅薄膜生长速率分别为6.12、6.06、6.13、5.98和6.14nm/min,基本一致。
在表3条件下制备的多晶硅薄膜厚度分别为9、97、147、197和246nm,不同厚度下薄膜的钝化性能测试结果如图9所示。
当多晶硅薄膜厚度为49nm时,Vioc平均值为685mV,J0平均值为21.90fA/cm2;当多晶硅薄膜厚度为97nm时,Vioc平均值723mV,J0平均值为4.17fA/cm2,钝化质量显著提升;当多晶硅薄膜厚度为147、197和246nm时,Vioc平均值分别为747、749和747mV,J0平均值分别为1.68、1.46和1.84fA/cm2,相对于97nm的厚度,此三种厚度下薄膜的钝化性能更佳,且基本一致。
这表明当多晶硅薄膜厚度为147nm时,已经满足钝化性能要求,进一步增加厚度并不能继续显著提升钝化质量。
采用33min沉积时间制备多晶硅薄膜厚度为197nm的TOPCon电池,其平均光电转换效率达到24.37%。
综上所述,影响多晶硅薄膜生长速率和钝化质量的重要因素有沉积温度、硅烷体积流量和沉积时间。
在590~635℃沉积温度内,随着温度增加,多晶硅薄膜生长速率明显增大,钝化性能先变优再变差,600℃时钝化性能最佳。
在250~1150cm3/min硅烷体积流量内,多晶硅薄膜的生长速率与硅烷体积流量基本呈线性关系,钝化性能在硅烷体积流量较低时基本稳定,当硅烷体积流量为1150cm3/min时钝化性能明显变差。多晶硅薄膜生长速率基本不受沉积时间影响,当多晶硅薄膜厚度为49~246nm时,钝化性能先变优后趋于稳定。
当硅烷体积流量为790cm3/min、反应压力为180mTorr、沉积温度为600℃、沉积时间为33min、多晶硅薄膜厚度为197nm时,样品的Vioc平均值为749mV,J0平均值为1.46fA/cm2,钝化性能最佳,优于行业内Vioc约730mV、J0约2fA/cm2的平均水平。该条件下制备的TOPCon电池,其平均光电转换效率达到24.37%,高于23.6%~24%的行业平均光电转换效率。
原文始发于微信公众号(光伏产业通):LPCVD制备多晶硅薄膜的性能